www.konstruktion-industrie.com
01
'26
Written on Modified on
ZEISS verbessert FIB-SEM-Präzision mit Crossbeam 750
Neues System kombiniert Echtzeit-SEM-Bildgebung und FIB-Fräsen mit Gemini-4-Optik zur Verbesserung der Endpunktgenauigkeit und 3D-Analyse-Workflows.
www.zeiss.com
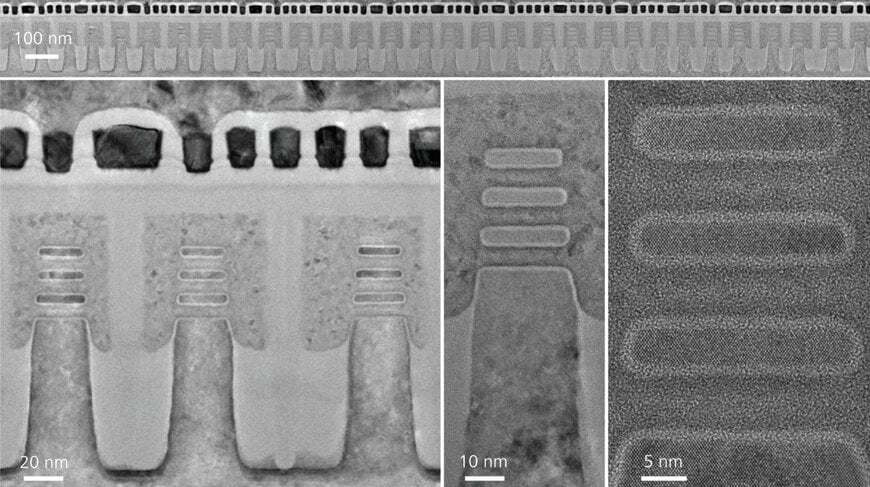
Analysen in der Halbleitertechnik, Materialwissenschaft und Nanofabrikation erfordern eine präzise Probenpräparation, hochauflösende Bildgebung und eine genaue Endpunkterkennung im Nanometermaßstab. In diesem Zusammenhang hat ZEISS das Crossbeam 750 FIB-SEM vorgestellt, das darauf ausgelegt ist, gleichzeitiges Fräsen mit fokussiertem Ionenstrahl (FIB) und Rasterelektronenmikroskopie (SEM) zu ermöglichen, um eine kontinuierliche Prozesskontrolle während der Probenpräparation sicherzustellen.
Das System integriert Echtzeit-Bildgebung mit Fräsoperationen, sodass Anwender den Materialabtrag und die strukturelle Entwicklung überwachen können, ohne den Prozess zu unterbrechen. Dieser Ansatz adressiert eine zentrale Einschränkung konventioneller FIB-SEM-Workflows, bei denen intermittierende Bildgebung zu Ungenauigkeiten bei der Endpunkterkennung und erhöhtem Nachbearbeitungsaufwand führen kann.
Echtzeit-„Sehen während des Fräsens“-Prozesskontrolle
Das Crossbeam 750 ermöglicht kontinuierliche SEM-Bildgebung unter allen Fräsbedingungen, von hochstromigem Materialabtrag bis hin zu feinem Polieren bei niedrigen Beschleunigungsspannungen bis zu 0,5 kV. Diese Fähigkeit erlaubt es Bedienern, FIB–Proben-Interaktionen direkt zu beobachten und Parameter in Echtzeit anzupassen.
Diese Kontrolle ist besonders relevant bei der Präparation von Lamellen für die Transmissionselektronenmikroskopie (TEM), bei der eine gleichmäßige Dicke und minimale Schäden erforderlich sind. Durch die Aufrechterhaltung der Sichtbarkeit während des gesamten Prozesses unterstützt das System den Erfolg beim ersten Durchlauf in der Lamellenherstellung und reduziert den Bedarf an iterativen Korrekturen.
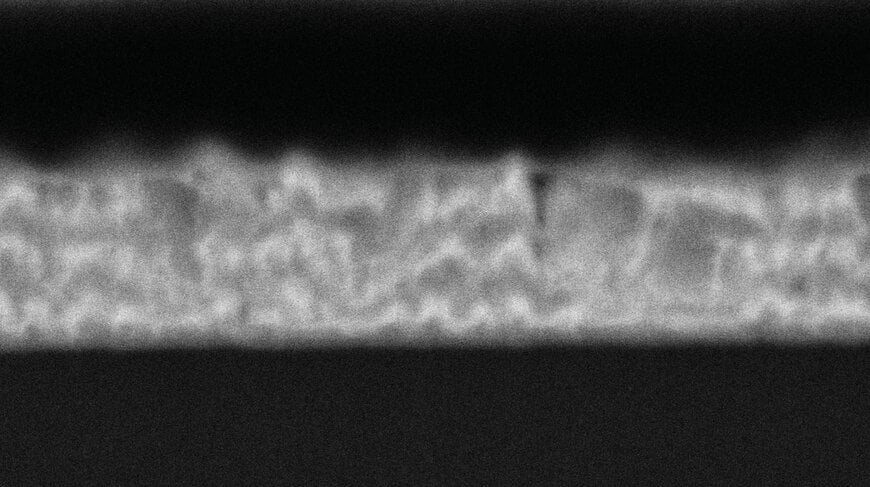
Gemini-4-Optik für hochauflösende Bildgebung
Das System integriert die neue Gemini-4-Elektronenoptik, die eine verbesserte Auflösung und ein besseres Signal-Rausch-Verhältnis bietet. Dies ermöglicht eine hintergrundfreie Bildgebung und eine stabile Leistung bei niedrigen Aufsetzenergien, was für empfindliche Materialien und hochpräzise Analysen entscheidend ist.
Die verbesserte Bildgebungsleistung unterstützt Anwendungen, die eine detaillierte strukturelle Charakterisierung erfordern, einschließlich fortschrittlicher Halbleiterbauelemente und nanoskaliger Materialsysteme.
Anwendungen in fortschrittlichen Halbleiter- und Material-Workflows
Das Crossbeam 750 ist für den Einsatz in Halbleiteranwendungen modernster Knoten ausgelegt, einschließlich Logik- und Speicherbauelementen, die auf Architekturen wie Gate-all-around (GAA) und komplementären FET (CFET) basieren. Diese Strukturen erfordern eine Genauigkeit im Nanometerbereich während der Querschnittserstellung und Probenverdünnung.
Über Halbleiter hinaus unterstützt das System eine Vielzahl von Anwendungen in der Material- und Lebenswissenschaft, darunter:
- TEM-Lamellenpräparation für hochauflösende Mikroskopie
- Probenpräparation für Atomsondentomographie (APT)
- Nanofabrikationsprozesse wie Elektronenstrahllithographie
- Dreidimensionale (3D) Volumenbildgebung und Tomographie
Das große, unverzerrte Sichtfeld des Systems verbessert die Datenqualität in der 3D-Tomographie, während stabile Niedrig-kV-Bildgebungsbedingungen den Kontrast erhöhen und die Aufnahmezeit reduzieren.

Verbesserter Durchsatz und Reproduzierbarkeit
Durch den Wegfall der Notwendigkeit, das Fräsen für die Bildgebung zu unterbrechen, rationalisiert das Crossbeam 750 die Workflows und reduziert die Gesamtbearbeitungszeit. Die kontinuierliche Überwachung ermöglicht konsistentere Ergebnisse, insbesondere in Umgebungen mit hohem Durchsatz, in denen Reproduzierbarkeit entscheidend ist.
Die Fähigkeit, präzise Endpunkte beim ersten Versuch zu erreichen, ist besonders wertvoll in der Halbleiter-Fehleranalyse und Prozessentwicklung, wo Abweichungen im Nanometerbereich die Bauelementleistung beeinflussen können.
Positionierung innerhalb von FIB-SEM-Systemen
FIB-SEM-Plattformen werden häufig für die Probenpräparation und Analyse im Nanometerbereich eingesetzt. Vergleichbare Systeme sind die Helios-Serie von Thermo Fisher Scientific und die FERA-Plattformen von Tescan, die ebenfalls Ionenstrahlfräsen mit Elektronenbildgebung kombinieren.
Wichtige Differenzierungsmerkmale in diesem Segment sind die Bildauflösung bei niedrigen Spannungen, die Echtzeit-Prozesssichtbarkeit und die Qualität des Sichtfelds für die 3D-Rekonstruktion. Die Integration kontinuierlicher SEM-Bildgebung während des Fräsens und verbesserter Elektronenoptik im Crossbeam 750 zielt auf diese Leistungsparameter ab, insbesondere für fortschrittliche Halbleiterknoten und hochpräzise Materialforschung.
Durch die Kombination von gleichzeitiger Bildgebung und Fräsen mit verbesserter optischer Leistung erfüllt das Crossbeam 750 die sich entwickelnden Anforderungen in der nanoskaligen Fertigung und Analyse, bei denen Prozesskontrolle und Bildtreue die Ergebnisse direkt beeinflussen.
Bearbeitet von Natania Lyngdoh, Induportals-Redakteurin — Adaptiert von KI.
www.zeiss.com

Verbesserter Durchsatz und Reproduzierbarkeit
Durch den Wegfall der Notwendigkeit, das Fräsen für die Bildgebung zu unterbrechen, rationalisiert das Crossbeam 750 die Workflows und reduziert die Gesamtbearbeitungszeit. Die kontinuierliche Überwachung ermöglicht konsistentere Ergebnisse, insbesondere in Umgebungen mit hohem Durchsatz, in denen Reproduzierbarkeit entscheidend ist.
Die Fähigkeit, präzise Endpunkte beim ersten Versuch zu erreichen, ist besonders wertvoll in der Halbleiter-Fehleranalyse und Prozessentwicklung, wo Abweichungen im Nanometerbereich die Bauelementleistung beeinflussen können.
Positionierung innerhalb von FIB-SEM-Systemen
FIB-SEM-Plattformen werden häufig für die Probenpräparation und Analyse im Nanometerbereich eingesetzt. Vergleichbare Systeme sind die Helios-Serie von Thermo Fisher Scientific und die FERA-Plattformen von Tescan, die ebenfalls Ionenstrahlfräsen mit Elektronenbildgebung kombinieren.
Wichtige Differenzierungsmerkmale in diesem Segment sind die Bildauflösung bei niedrigen Spannungen, die Echtzeit-Prozesssichtbarkeit und die Qualität des Sichtfelds für die 3D-Rekonstruktion. Die Integration kontinuierlicher SEM-Bildgebung während des Fräsens und verbesserter Elektronenoptik im Crossbeam 750 zielt auf diese Leistungsparameter ab, insbesondere für fortschrittliche Halbleiterknoten und hochpräzise Materialforschung.
Durch die Kombination von gleichzeitiger Bildgebung und Fräsen mit verbesserter optischer Leistung erfüllt das Crossbeam 750 die sich entwickelnden Anforderungen in der nanoskaligen Fertigung und Analyse, bei denen Prozesskontrolle und Bildtreue die Ergebnisse direkt beeinflussen.
Bearbeitet von Natania Lyngdoh, Induportals-Redakteurin — Adaptiert von KI.
www.zeiss.com
Fordern Sie weitere Informationen an…

